
主要产品为半导体,光伏⽤焊接材 料,适⽤于IGBT, MEMS,SIP, Mini LED,PV等相关产品, ⼴泛应 ⽤于Flip Chip,Wire Bonding 等各种封装⼯艺中Die Bonding, BGA ball attach,Passive Components Attach以及各种半 导体光伏应⽤中的细分领域。焊膏具有优良的浸润性, ⾮常明亮的焊点,极好的 焊性强度,优良的可靠性,并⼴泛包容多种合⾦,宽容的回流曲线。
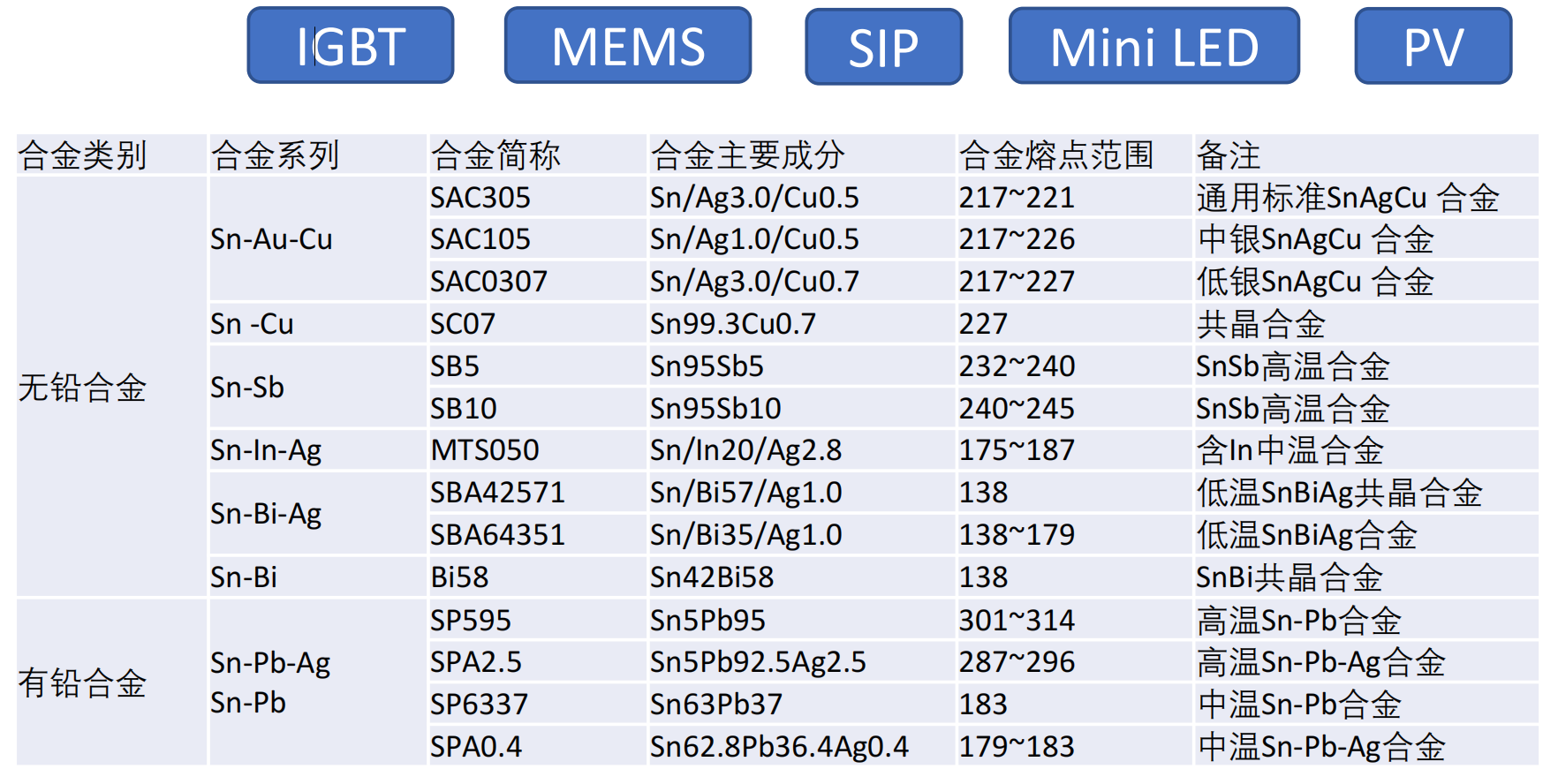
半导体,光伏,SMT 等⾏业各种被动元器件焊接
MSM-5118WP/MSM-5228WP/MSM-5158P
特点:
▪优异的抗热坍塌性
▪⻓时间的钢⽹使⽤寿命
▪卓越的润湿性能
▪低空洞,宽容的回流曲线
▪多种合⾦(SAC105/305, SC07,SB5/10)
| 属性 | MSM-5118WP | MSM-5228WP | MSM-5158P |
| 助焊剂分类 | ROL1 | ROL1 | ROLO |
| 锡膏类别 | 水基 | 水洗 | 免洗 |
| 粘性(cps) | 180±40 | 180±40 | 180±40 |
| 合金含量 | 88.5±1% | 88.5±1% | 88.5±1% |
| 表面绝缘阻抗 | PASS | PASS | PASS |
| 保质期 | 6 month | 6 month | 6 month |
半导体先进封装及汽⻋电⼦元件封装:IGBT, MEMS, SIP, MiniLed
MSM-5458D/MSM-5558D/MSM-5658D
特点:
▪⾼活性与优越润湿性
▪⾮常明亮的闪亮焊点
▪极好的焊性强度及可靠性
▪⼴泛的回流曲线
▪多种合⾦,(SAC305,SC07,SB5/10)
半导体先进封装:Die Bond, Die Attach
MSM-9159D/MSM-9259D/MSM-9169D
MSM-9159D/MSM-9259D/MSM-9169D
半导体先进封装:Ball Attach 助焊膏
F880W/F990HF 广泛用于BGA 锡球的焊接 並可依客戶需求而研發生產
| 含鉛錫球 | 熔点(℃) |
Sn10/Pb90 | 275-302 |
Sn62/Pb36/Ag2 | 179E |
| Sn63/Pb37 | 183E |
無鉛錫球 | 熔点(℃) |
Sn99.3/Cu0.7 | 227 |
Sn96.5/Ag3/Cu0.5 | 217-218 |
Sn96.5/Ag3.5 | 221E |
Sn95/Sb5 | 245 |
| Sn42/Bi58 | 138 |


